報名結束
Ansys Icepak封裝散熱分析課程
| 地區 | 日期 | 上課時間 | 承辦人員 |
|---|---|---|---|
| 板橋 | 4/17 | 09:30~17:00 | 台北:(02)2956-7575#602 莊小姐 benny.zhuang@cadmen.com |
| 上課大綱 | |
|---|---|
|
隨著時代的進步,電子與光電產品朝向輕薄短小以及功能、速率不斷提昇的趨勢發展,散熱問題也越來越嚴重。而熱的分布越來越不均勻,晶片將持續在高熱狀態下運作,使用壽命也會呈指數性衰減,造成產品的可靠度問題。此種情形是晶片業者所不願樂見的。
現在新的設計趨勢是提前將散熱設計考慮進去;在晶片設計製程或是更前端的晶片封裝階段就進行散熱分析,如此才能獲得更大程度的散熱效果。 因此無論從晶片層級、封裝層級到系統層級,對散熱的要求只會愈來愈高,這已非傳統散熱材料所能滿足,唯有做好晶片封裝的散熱設計方可以大幅降低產品熱的問題。
 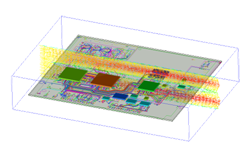 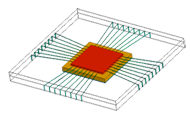
上課內容
Chap 1:Icepak在IC封裝上的應用
Chap 2:Icepak基礎操作演練 Chap 3:在IC封裝上的實際操練 ▪ IC封裝幾何建立 ▪ Layout線路輸入 ▪ 邊界條件設定 ▪ 基礎網格設定 ▪ 求解 ▪ 後處理顯示 ▪ 參數化分析設定 Chap 4:Ansys熱傳結構耦合分析
課程對象
● 電子封裝、模組熱管理設計工程師
● 電子產品系統工程師
● 機構散熱設計工程師
課程目標
● 透過講師豐富的經驗並搭配實機操作, 可快速透過Icepak習得IC封裝的熱流與熱固耦合分析應用。cepak在IC封裝上的應用
延伸課程
● Ansys CFD Post結果後處理課程
● Ansys Icepak電子散熱分析課程
● Ansys Icepak幾何模型建構與網格處理課
|
|
報名結束
返回列表